A place that you can publish and share ideas, new products and new technologies which improve the existing plasma technologies/applications or create a brand new one. Plasma Circus is also a forum for all kinds of plasma applications.
2009/07/01
另外一個迷思: PEM的閉鎖迴路控制要用MFC或是PZT valve
到底要用MFC (Mass Flow Controller)就能夠擔負製程的重責大任? 還是需要使用PZT valve?
用一個很簡單的模型來分析就可以做出正確的判斷,不會選擇錯誤了。
要達成一個PEM閉鎖迴路控制的製程,需要下列的物件才能完成。
1. 感測頭: 將電漿光譜的光線收集傳遞給偵測器。這通常是由光學鏡頭與光纖組成的硬體,將光訊號傳遞到偵測器做光電訊號的轉換。因為是光速在傳遞訊號,所以需要的時間可以忽略。
2. 偵測器: 有感度十分靈敏的光電倍增管PMT (Photo-Multiplier Tube),通常轉換時間小於1 ns; 另外一種是CCD偵測器,轉換時間大約需要1~2 ms。
3. CPU / MPU軟體處理: 光訊號轉成電的訊號,經由電腦軟體的計算與處理產生可做控制的訊號輸出,需要的時間大約5-10 ms。
4. MFC或是PZT Valve: 控制反應性氣體流量的閥門從接收到電腦傳來的控制訊號到調整閥門開啟的大小到達指定的位置所需的時間,好的MFC最快可以在幾個ms達成,PZT Valve可以在小於1 ms內達成。
5. 氣體管路: 氣體經過氣閥後需要流經氣體管路到達真空噴出的位置,這段時間視真空鍍膜系統的真空抽氣設計來決定長短,通常需要20 ms(系統有很好的真空抽氣設計)到200 ms不等。
6. 擴散: 氣體抵達真空內部的噴嘴位置,會依照當時真空度的製程條件以擴散的方式離開噴嘴到達電漿製程的區域,這段時間通常小於1 ms.
重複這六個步驟就是一個完整的電漿反應性閉鎖迴路的控制流程。
因此,也很容易看出使用好的MFC大致就能滿足這種製程的要求了。
使用PEM在成膜均勻性與均質性的迷思
要改善待鍍物表面成膜厚度的均勻性,需要從鍍膜設備的硬體設計下手,舉凡使用的幫浦種類、規格、抽氣位置與供氣的氣導設計,以及製程的條件要求等等。一旦成膜厚度的均勻性能夠達到一定的水準,在來使用PEM讓每個鍍膜控制區域內的成膜品質有最佳化的表現。這樣子才能讓均勻性與均質性的表現兩全其美。
2009/06/27
How long to clean the protection device of collimator
Plasma Emission Monitor (PEM)的分類
(a) lens filter type(濾光片型)
(b) spectroscopic type(分光型)
(a) 濾光片型的每個頻道只能一次看一個波長,如果要看另外一個波長,就需要更換濾光片。通常此濾光片以中心波長為主,向長波與短波方向延展大約各5nm。所以,濾光片型的PEM沒有所謂的光譜解析度,濾光片能看到的是包含很寬廣的一個積分光譜區域。因為全光譜都被此濾光片濾光了,所以通過的光線強度十分微弱,因此需要一個很靈敏的偵測器來取得光線的強度資訊並加以放大成為可以分析使用的電訊號。所以,濾光型的光感應裝置包含: 一個防鍍的準直鏡頭(一根小管子,不是蜂巢)、一片濾光片、一個PMT(Photo-Multiplier Tube)光電倍增管偵測器,來把光的訊號轉成電的訊號。
(b) 分光型的每個頻道使用陣列方式的arrayed CCD分光光譜儀,可同時看到分佈在200nm-1100nm光譜範圍內的2048個光譜譜線資料,光學解析度可達1.4nm。光感應的裝置包含: 一個安裝蜂巢式的防鍍裝置的準直鏡頭、真空內部導光的石英光纖、光纖導光用的真空法蘭、外部導光的石英光纖、arrayed CCD分光光譜儀。
2009/06/19
如何應用OES tool與RGA tool
說明如下:
- RGA能看到環境的氣體成分比例與變化,但是無法看到實際參與電漿製程(等離子工藝)的物種與變化,OES卻可以。這是最大的差異。
- 其次,RGA的反應遲緩,OES可以快速反應。 因此,RGA對於製程(工藝)上出了狀況是很難追蹤與了解實際電漿製程(等離子工藝)的變化。只有使用OES才有機會知道製程(工藝)中真實發生的情形,進而可以找到解決之道。
- RGA可以當做OES的輔助,兩者相輔相成。
結論: OES掌握製程(工藝)的穩定性,RGA去處理整體環境的穩定性。
2008/08/26
Improvement of the response time for a fast PID closed loop control
Of course, this technology can be used for any kind of applications with the demands on different settings for the recording intervals, but the response time is demanded to be very high. Now, only Plasus EMICON MC/HR series can do it.
2007/03/17
Basics of plasma spectroscopy
知名的德國學者Dr. Ursel Fantz (烏契兒.芳契博士)受邀在IOP期刊發表一篇文章:"Basics of plasma spectroscopy" (電漿光譜學之基礎),我們推薦值得一讀。請在下面的網站直接下載:
http://www.iop.org/EJ/abstract/0963-0252/15/4/S01.
2006/12/04
二氧化矽雙靶反應濺射鍍膜
2006/09/16
EmiCon System的工作原理介紹
電漿的形成在於原子或分子上的電子受到外來電場游離,再誘發二次電子撞擊更多的原子與分子產生更多的游離態原子與分子,只要外來電場持續供應且環境維持穩定,電漿就能繼續存在。當不同原子與分子上的電子在高低能階之間跳躍,會釋放與吸收各種特定的能量,釋放的能量可用光的波長形式來詮釋,故同一原子或分子內不同能階軌域的電子產生的跳躍,會同時以不同波長的光把能量釋放出來。分析電漿釋放出來的光譜可以得知參與製程反應的電漿物種,進而找出控制反應機制的主要參數。因此,如何控制與觀察電漿的運動與作用就成為一項艱深的學問。
為了研究存在電漿中的各種不同帶電離子與分子的成分與分布,在不影響電漿反應機制的條件下,還能採用回綬控制的方式來穩定製程,光學偵測法是不接觸電漿也不影響電漿作用的唯一選擇,其中能夠完全表現電漿特性的就是採用分光光譜學的量測技術加上特殊設計的回綬控制機制來達到分析電漿物種與穩定製程的雙重目的。其中以OES (Optical Emission Spectroscopy)光放射光譜學的技術最為成熟。為了達到回綬控制的目的,電漿放射出來的光線經由一個準直鏡光學鏡頭焦聚到石英光纖,傳送到分光儀把電漿的光線用光柵分光到一個陣列式的光偶合感測器(Arrayed CCD),每一個感測器上的獨立感測單元代表一個分光後的特定波長,整個陣列分佈把光的資訊轉化成有用的電壓資訊,電腦透過USB電纜取得這一瞬間電漿光線轉化成陣列對應電壓的光譜資訊,再由軟體針對選定的特殊譜線資料做進一步的PID回綬控制。
下圖為EmiCon回綬控制的示意圖
2006/08/06
多頻道等離子監控系統: EmiCon家族
Ion Assisted Co-Sputtering (離子輔助共同濺射)

2006/04/01
Pulsed DC脈衝直流電源不同應用的組合
 1. 雙極對稱式輸出
1. 雙極對稱式輸出 這種組合主要用在同靶材的反應式雙磁控濺射靶的鍍膜製程。SiO2, TiO2, Ta2O5, Al2O3, ITO, AZO等。利用改變脈衝作用與非作用的時間來控制濺鍍電漿的密度高低,在特定的電漿阻抗條件下,可優化濺鍍速率與薄膜品質。組合如下:
1.1 脈衝產生控制器 X 1
型號MAGPULS 1000/30/100 bp
• +/- 0-1000V輸出
• 30安培直流輸出(Max.)
• 100安培脈衝電流輸出(Max.)
1.2 直流電源供應器 X 1
型號MAP 1000/20
• 0-1000V輸出
• 0-25安培直流輸出(Max.)
註:在400伏特的濺鍍製程有最大電流輸出25安培。
2. 雙極非對稱式輸出 
這種組態大量用在單靶的反應式濺鍍製程以及氮化物硬膜的治具偏壓用途。也有用於雙靶特殊混合的陶瓷合金濺鍍製程。組合如下:
2.1 脈衝產生控制器 X 1
型號MAGPULS 1000/30/100 bp
• +/- 0-1000V輸出
• 30安培直流輸出(Max.)
• 100安培脈衝電流輸出(Max.)
2.2 直流電源供應器 X 1
型號MAP 1000/3 (供應正電壓)
• 0-1000V輸出
• 0-3安培直流輸出(Max.)
2.3 直流電源供應器 X 1
型號MAP 1000/20 (供應負電壓)
• 0-1000V輸出
• 0-25安培直流輸出(Max.)
2006/03/27
脈衝直流電源問答集
A1: RF的電源與DC或是脈衝DC電源一樣有好多種等級,一般可以從RF電源的規格敘述中知曉是否具有抑制與偵測ARC的功能。其原理與直流電源類似,感知突發的大電流所產生的斜率大小來判斷。一旦確認ARC發生,也是將所有供電中止,經過一個延遲的時間後再次觸發電漿,繼續製程。
RF電源也有所謂的脈衝RF電源,主要目的是希望能夠更有效率地防止ARC的發生。
Q2: MAGPULS可設定輸出的Frequency,其作用是在何地方? 會對膜的品質有影響嗎?
A2: MAGPULS與其他電源不同,可以針對製程所需來改變電漿的作用與非作用時間,頻率可以利用週期的倒數計算得到(f=1/T)。其他電源因為設計不同而無法提供如此準確與詳細的作用時間控制方法,只好用頻率來說明他們的作用時間。
作用時間的長短會依製程的不同產生電漿製程的控制參數之間的移轉。當作用時間越短,越是偏向電壓控制模式,也就是實際作用的電壓會接近或等於設定的電壓值。當作用時間變長,電壓會逐漸降低,且脈衝電流與平均值流電流會增加,直到達到飽和電流,此時,無論增加任何作用時間將無法再增加脈衝電流與直流電流。
利用這種作用時間的可調性,可以改變電漿製程達到調製不同的薄膜品質的目的。
Q3: 在執行非對稱式濺鍍並加偏壓時,磁控靶是否都使用負輸出,而偏壓使用正輸出,可加強膜的附著力?
A3: 濺鍍靶的靶面都是接到低電位的極性。MAGPULS採用正電場的觀念,輸出端的正與負代表電場方向由正(高)往負(低)。所有UP+與DC+都是把正端(高電位)接到真空腔體上接地,負端(低電位)接到靶材,這樣子才能把Ar離子加速撞擊靶材產生濺鍍。如果正負端正好接反了,只要在MAGPULS內部選用相反極性的模式操作就可以了。因為”負負得正”的道理,很簡單的。
加了偏壓當然對薄膜的附著力有增強的效果。用正電場的觀念,在加偏壓的待鍍物上必須接低電位(UP+模式的負端)。
Q4: 抑弧參數可自行設定,但其參考依據為何?
A4: MAGPULS在輸出端安裝有一個高速的電流感測器,可以同步感知透過輸出迴路帶回來的電漿狀態,當電漿製程發生電弧,電流感知器立即將此突發的脈衝電流與比流器(comparator)中設定的Arc-Level數值比對,如果感知器的數值高於Arc-Level的設定值,MAGPULS就把這次的比對當作偵測到一次電弧。接著由MAGPULS內部的電腦計算累計偵測到的電弧次數是否在設定的時段內達到預先的設定數目,再來判定是否要在LCD面板上顯示電弧發生的次數。
要判斷是否為真正的電弧,只要從較短的作用時間做起,慢慢地把作用時間加長,同時把電流的Arc-Level設定值也加大,直到沒有任何的ARC記錄顯示在LCD為止。如果Arc-Level放到最大還有ARC記錄顯示,這代表電漿製程內真的有電弧的發生。
Q5: 學術單位執行反應式濺鍍時多用RF,若改用MAGPULS可將濺鍍速率提高多少?還有哪些優點?
A5: 舉一個鍍TiO2的例子做比較:
RF最大的飽和鍍膜速率: 1500nm/h,也就是4.16Å/s
DC Pulsed的普通濺鍍速率在40Å/s以上
兩者大概差十倍。其他材料也都大同小異。
優點:
1. 磁控靶的最大功率限制才是DC Pulsed的鍍膜速率上限。如果磁控靶可以耐到20KW,你用一套10KW的Pulsed DC就無法發揮最大的鍍膜速率。但是RF的先天限制,其飽和鍍膜速率一旦達到,無論電源的功率提高多少都無法再增加任何一點的鍍膜速率。
2. ARC可以很有效控制。
3. 擴大製程可調整的空間,可以變動作用時間與電流參數做出不同品質的薄膜。
2005/12/28
703nm 重要的氟譜線

使用內真空感測器可以隨意安置,取得最佳的製程監測方位。
2005/12/27
What's the difference between the intensity listed in the database and the actual measurement?
The radiation we are measuring with the EmiCon OES system is due to a two-step process in the plasma:
1. Ground state atoms are excited by electron collisions in higher electronic levels. The density of the excited atoms in a specific electronic level depends on the energy gap between the ground state (0 eV) and the higher electronic level and the electron temperature (i.e. electron energy distribution function EEDF, often Maxwelliam). The larger the gap the less is the density of the atom in this specific energy level.
2. From the higher electronic level the atom is decaying by spontaneous emission to some lower electronic level. This is the radiation we are measuring. The intensity given in the SpecLine database is the probability that the atom in the specific higher electron level will decay into the given lower electronic level.

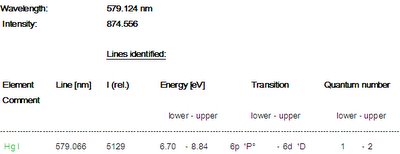
This means for the Hg spectrum:
A.The lines at 404 nm, 435 nm and 546 nm are all decaying from the electronic level 7s2S with energy 7.73 eV. These there lines show an intensity distribution as given by the intensity values of the SpecLine database.
B. The line at 365 nm is decaying form the electronic level 6p2P° with energy 8.85 eV and the line 579 nm is decaying from the electronic level 6p1P° with energy 8.84 eV. Allthough these lines have a higher probability to decay than the lines form the 7s2S level, the denstiy of atoms in the 6p levels is much smaller due to the higher energy of the excited level (8.85 eV and 7.73 eV for the 7s level).
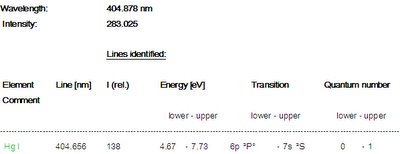
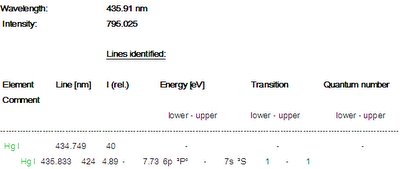
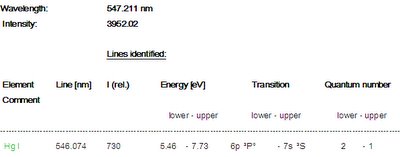
In general, the intensity of a line is ruled first by the excitation process (i.e. the energy of the higher electronic level) and second by the probabilty of decaying from the higher level to a lower level.
The remaining differences in the intensities of the lines is due to the sensitivity distribution of the EmiCon system, i.e. the system is most sensitive between 450 and 550 nm and less sensitive below 400 nm.
~~~ supported by Dr. Thomas Schütte of PLASUS ~~~
2005/12/26
Multi-channel plasma monitoring and controlling system is available
It has been taking a long time to develop the multi-channel plasma emission monitoring and controlling system. I'm very appreciated in so many friends and customers who devoted themselves in the testing and gave us their great supports. Here is a picture for the product family.
More information will be updated later.
2005/07/14
In-vacuum optics protection device
 Plasma process is extremely exciting and any in-vacuum optics is easily contaminated by unexpected coatings on mirrors or lenses which are essential to keep the best optical performance for metrology instruments. A special designed in-vacuum optics protection device is able to prevent most of the strong contaminations from the plasma processes, such as sputtering, plasma-CVD or etching. With applying this device, the monitoring stability of plasma process control is assured and preventive maintenance is extended tremendously as well.
Plasma process is extremely exciting and any in-vacuum optics is easily contaminated by unexpected coatings on mirrors or lenses which are essential to keep the best optical performance for metrology instruments. A special designed in-vacuum optics protection device is able to prevent most of the strong contaminations from the plasma processes, such as sputtering, plasma-CVD or etching. With applying this device, the monitoring stability of plasma process control is assured and preventive maintenance is extended tremendously as well.~~~ Supported by Dr. Thomas Schütte of PLASUS ~~~
2005/07/13
Welcome to Plasma Circus

 Figure 1. 從視窗觀看雙靶濺射鍍膜製程
Figure 1. 從視窗觀看雙靶濺射鍍膜製程
